图1 一种容性耦合等离子体放电现象

由于刻蚀过程中复杂的物理和化学反应, 不同中性粒子、带电粒子间的场(电场,流场,力场等)的相互作用,使得plasma刻蚀很难描述。一些文章中都是针对初学者简单的介绍了等离子体刻蚀中的主要几个过程,但是对于原理性的描述非常有限。Nasser, “Fundamentals of Gaseous Ionization and Plasma Electronics”, John Wiley & Sons, 1971,Chapman, “Glow Discharge Processes”, John Wiley & Sons, 1980两本经典书籍全面的介绍了等离子体的基本物理定律和现象。物理和工程领域的相关人员可从此两本书中了解等离子体技术。
容性耦合等离子体(CCP)
图2 等离子体中的激发碰撞与光谱辐射
图3 常用CCP源的腔室结构
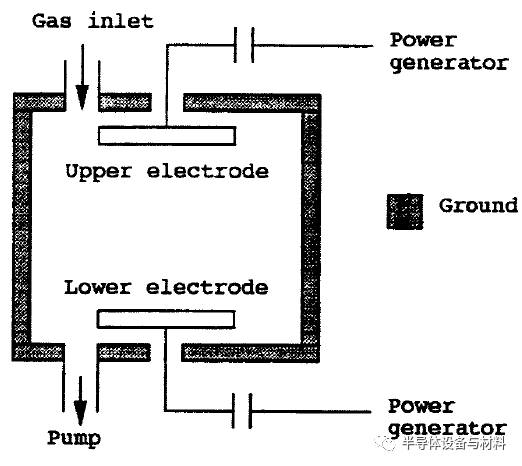
容性耦合等离子体放电气压范围往往从几个毫托到几百毫托,因为电子质量远低于离子质量,电子可以运动更远更长的距离并与气体和器壁进行碰撞,电离出更多的电子和离子。而器壁周围因为电子游离只留下笨重的离子,但整个腔室必须保证电中性,故必然会在器壁形成一种结构来阻挡电子继续在器壁周围的电离,而这种结构平衡了等离子体的电中性特性。这种结构即鞘层,鞘层可认为前面所说的电容器,因为电容器处于放电环境中,表面有电荷积累,就形成了一个电场,一个电场必然对应一个电压,因为电容器周围达到的电荷积累动态平衡,故这个电场,电压为动态的静电场,即直流电场和直流电压,故VDC形成。因为腔室内壁接地,而形成的偏压电场为阻止电子,故对地内壁而言此VDC为负值,即负偏压。在电极上此负偏压与射频电压一起形成了复合电压,如下图。

2. 1VDC该公式可适用于任何电极结构,如果电极1加载功率,电极2接地,其VDC形成如下图所示。
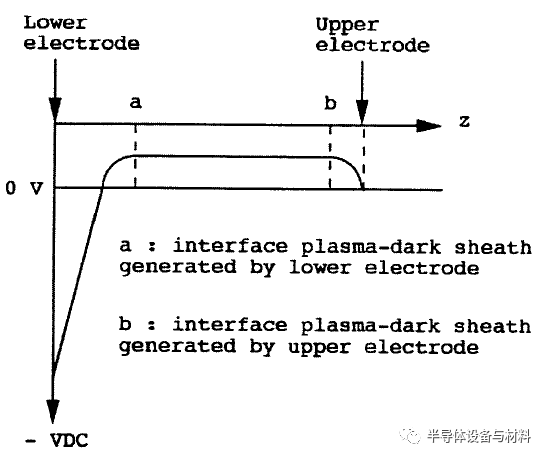
2.1.2.1 电负性气体是一个主要因素,当其他过程参数保持一定时,气体的电负特性将决定VDC。地电负性气体如O2,N2有较高的负偏压VDC,含F,Cl,Br的气体有更强电负性,因为VII族的元素很容易吸附自由电子。因子在含F,Cl,Br的气体中电子密度会大大降低。含F比含Cl气体电负性更强, SF6为典型的电负性气体。
2.1.2.2 气压也影响VDC,高气压,更多的分子、原子与电子碰撞,产生新的电子和离子,因此通过提高气压,增加更多的自由电子,提高了负偏压。另一方面,气压增加,密度增加,电子的平均自由程降低,在和分子碰撞之前,电子获得能量减小,导致新的电子、离子减少。因此两个方面相反的趋势,对于等离子体刻蚀,可以看到,1-100mT范围内,等离子密度随气压增加而增加,但更高的气压,密度随气压增加而降低。VDC也与自由电子能量相关,高气压,电子碰撞增加,电子能量因碰撞而降低。考虑到这些机制,我们可以理解VDC随气压增加并不会持续增加。
功率
2.1.2.4当Wafer放置在下电极上,可以在等离子体和Wafer之间得到较高的电压降即VDC。当电负性气体添加时,在低气压下,我们可以获得高的电压降VDC,对于高功率,RIE反应离子刻蚀,我们可以通过以上途径获得高VDC。如果要获得低的VDC则从反方向条件着手。
刻蚀机制
通常,等离子体刻蚀是化学刻蚀,不是物理刻蚀,这意味着固体原子与气体原子反应形成化学分子,然后从基片表面移除形成刻蚀。因为VDC的存在,通常存在一定的基片溅射,对于大量的刻蚀,物理刻蚀效应很弱可以被忽略。
1. 2. 3. 表面化学吸附反应,形成化学键,并形成反应产物;
解吸附化学反应产物,并在Wafer表面移除,抽离腔室;
图6 等离子体刻蚀基本机制
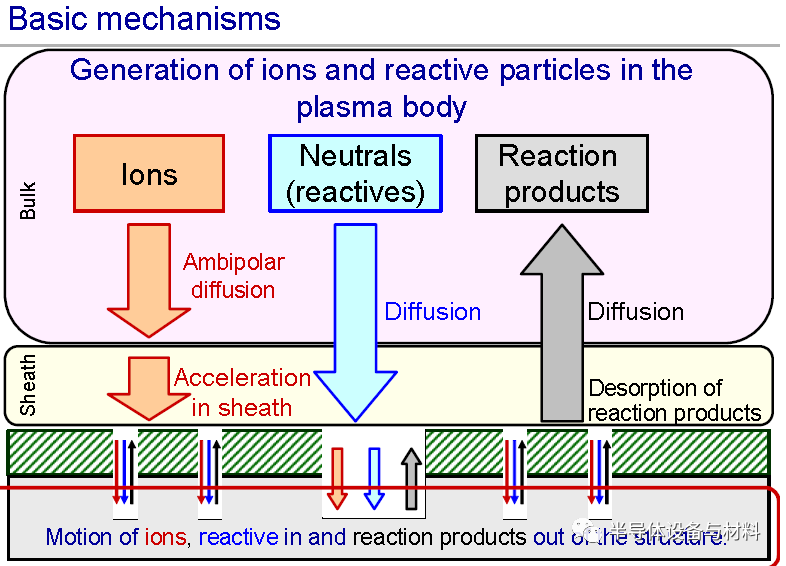
对刻蚀的影响
刻蚀速率,因为电子密度和能量与VDC相关联,故以上的化学反应过程与速率相对应;
离子轰击可以造成Wafer表面的建设损伤;而离子轰击的能量与VDC相关,VDC越高轰击越强;
离子轰击还会对刻蚀形貌有一定的影响等等
对于非易挥发性副产物,通过一定的离子轰击可以将副产物解离形成易挥发性产物,使本身在易在Wafer表面已形成的膜层消失;
图7 离子轰击作用

感应耦合等离子体(ICP)
两种类型的感应耦合等离子体源:采用柱形和平面结构,如图8所示。射频电流流经线圈在腔室内产生电磁场激发气体产生等离子体,偏压源控制离子轰击能量。通过这种方式,可以独立的控制等离子体密度和离子的轰击能量。因此ICP刻蚀机提供了更多的调控手段。
图8 两种方式的ICP结构
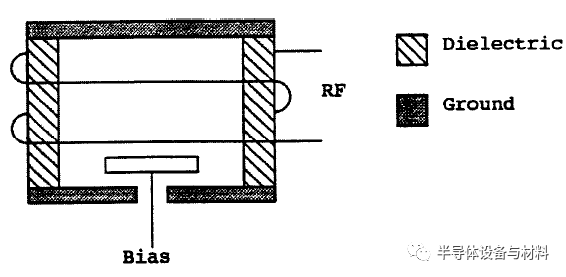
用于等离子体刻蚀的ICP源通常为平面结构,该方式容易获得可调的等离子体密度和等离子体均匀性分布,此外平面ICP源使用的介质窗也易于加工。石英和陶瓷是常用的介质窗材料。
此外感应耦合ICP源也存在容性耦合,介质窗作为线圈和等离子体之间的耦合层是作为一个电容器存在,在线圈的输出端电压达到2000V时,容性耦合将会形成。这个容性高压可以点燃和维持等离子体放电,另一方面,局部高压的形成也会导致介质窗的刻蚀,导致颗粒的产生或者造成晶圆的污染。为了减小容性耦合,通常采用法拉第屏蔽或者在线圈末端串联接地电容的方式。





